旭正精密【SiC / Si3N4】白光干涉(WLI)檢測實驗報告 報告
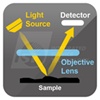
白光干涉儀(White Light Interferometer, WLI)是一種高精度的光學測量技術,能夠以納米級解析度檢測材料表面的微觀形貌。
在測量高密度陶瓷元件的鏡面表面時,WLI 能夠準確捕捉表面微缺陷,如凹陷、刮痕或孔洞。

研磨前 旭正SiC/Si3N4 畫面

拋光研磨後畫面
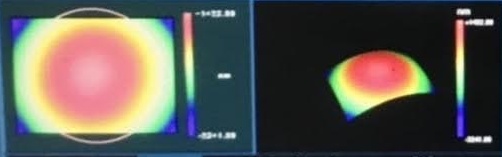
白光干涉檢測 旭正 SiC/Si3N4 畫面(一)

白光干涉檢測 旭正 SiC/Si3N4 畫面(二)
旭正 Si3N4 / SiC 經過精細拋光至鏡面狀態,利用 WLI 進行掃描分析,結果顯示表面連續且平滑,未發現孔洞或微裂縫。
由於 WLI 的縱向解析度可達 1 nm,橫向解析度亦可達 300 nm,若樣品內部存在孔隙且連通至表面,會在干涉圖中呈現高度變化。

白光干涉檢測 旭正 SiC/Si3N4 畫面
然而,本次測試未見異常,顯示該 Si3N4 / SiC 元件具有極低的孔隙率,材料結構緻密,製程品質優良。
透過白光干涉儀的無損檢測技術,我們能夠量化陶瓷表面的均勻性與完整性,為品質控制與製程優化提供科學依據。結果顯示,此 Si3N4 / SiC 樣品達到了高密度標準,適合作為高性能應用的關鍵材料。

白光干涉檢測 旭正 SiC/Si3N4 畫面